Schnelles, kompaktes spektroskopische Ellipsometer für In-situ-Messung bei ALD-Schichtwachstum

Abb. 1: Picosun R-200 Advanced ALD-Anlage mit montiertem iSE, Lichtquelleneinheit links, Empfängereinheit rechts montiert
Mit dem neuen iSE von Woollam Co. steht ein kompaktes, schnelles spektroskopisches In-situ-Ellipsometer zur Verfügung, welches gezielt für die Echtzeitüberwachung von dünnem Schichtwachstum entwickelt wurde. Das spezielle optische „Dual-Rotation“-Design erlaubt es, hochauflösend geringe Änderung von optischen Konstanten und Schichtdicken mit einer zeitlichen Auflösung von nur 0,3 Sekunden zu messen. Damit bietet sich das iSE u.a. als optimales Werkzeug für ALD-Prozesse an. Mit einem Spektralbereich von 400 bis 1000 nm können sowohl dielektrische, als auch metallische Schichten untersucht und deren Schichtdicken während des Beschichtungsprozesses bestimmt werden.

Abb. 2 Al2O3 auf Silizium. Gemessene Schichtdicke als Funktion der Zeit. Chuck-Temperatur 150 °C, 300 cycles, cycle-time 7,2 s, GR= 0,08 nm/cyc, Enddicke 25,3 nm
Die Abbildungen 2 und 3 zeigen Messungen von Al2O3- (Abb. 2) und TiO2-Schichten (Abb. 3) auf Silizium, während des ALD-Wachstumsprozesses, mit einer Picosun R-200 Advanced ALD-Anlage (Abb. 1). Man sieht sehr schön die hohe Schichtdicken- und Zeitauflösung, mit der es möglich ist, geringe Dickenänderungen während der einzelnen ALD-Wachstumszyklen aufzulösen.
Das spektroskopische Ellipsometer iSE hat einen breiten Spektralbereich.

Abb. 3a TiO2 auf Silizium. Gemessene Schichtdicke als Funktion der Zeit. Chuck-Temperatur 150 °C, 400 cycles, cycle-time 10,6 s, GR = 0,054 nm/cyc, Enddicke 20,7 nm

Abb. 3: TiO2 auf Silizium. Gemessene Schichtdicke als Funktion der Zeit. Chuck-Temperatur 150 °C, 400 cycles, cycle-time 10,6 s, GR = 0,054 nm/cyc, Enddicke 20,7 nm
Dadurch lassen sich auch metallische Schichten untersuchen und deren optische Konstanten und Schichtdicken bestimmen. An einer ALD-Anlage FlexAL von Oxford Instruments (Abb. 4) wurde das Schichtwachstum von Pt untersucht. Typischerweise formieren Metalle anfangs keine dichte Schicht sondern wachsen „in Inseln“. Um die Empfindlichkeit im Hinblick auf Schichtdicke und optische Konstanten zu erhöhen und zu gewährleisten, dass diese Parameter beim Fit nicht korrelieren, wurde die sogenannte „Interference-Enhancement-Methode“ angewandt.
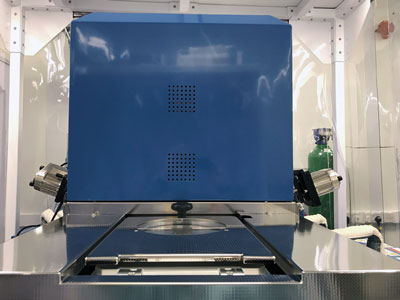
Abb. 4: Oxford Inst. ALD-Anlage FlexAL mit montiertem iSE

Abb. 5: Pt auf Si/SiO2. Gemessene Schicktdicke als Funktion der Zeit. Chuck-Temperatur 175 °C, Enddicke 18,2 nm
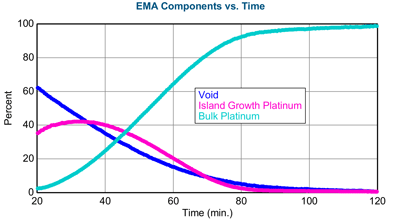
Abb. 6: Änderung des Verhältnisses von Bulk-, „Insel“-Pt und Void als Funktion der Wachstumszeit
Dazu wird die Pt-Schicht auf einer ca. 500 nm dicke SiO2-Schicht (auf Si) aufgewachsen. Die Schichtdicken-Interferenzen der dielektrischen Schicht werden mit zunehmender Pt-Dicke gedämpft, wodurch eine ausreichende Empfindlichkeit für alle zu ermittelnden Parameter gegeben ist. Dazu benötigt man jedoch ein Ellipsometer mit einem breiten Spektralbereich wie das iSE. Abb. 5 zeigt die Pt-Dicke als Funktion der Wachstumszeit. Die maximale Schichtdicke betrug 18,2 nm. Die Pt-Schicht wurde mit einem EMA-Modell aus optischen Konstanten für Bulk-Pt, aus optischen Konstanten von „Inselwachstums-Pt“ und Void (Luft) modelliert. Dabei wurden die Anteile von Bulk-, Insel-Pt und Void gefittet. Die Änderung der Anteile ist in Abb. 6 dargestellt.


