Scanning Microwave Microscopy (SMM)
Negli ultimi decenni, la spinta alla miniaturizzazione dell'elettronica ha aumentato la richiesta di metodi di caratterizzazione elettrica alla nanoscala. La comprensione delle proprietà locali dei materiali utilizzati in elettronica, come la conduttanza, la costante dielettrica, la capacità locale e la densità di drogaggio, è fondamentale per la ricerca e lo sviluppo dell'industria dei semiconduttori e della microelettronica.
La microscopia a forza atomica (AFM) è stata una importante tecnologia utilizzata per correlare le strutture topografiche con le proprietà elettroniche locali su scala nanometrica. Tecniche come la microscopia a forza atomica conduttiva (CAFM) e la microscopia a forza con sonda Kelvin (KPFM) consentono di misurare le correnti locali e i potenziali elettrici di superficie, mentre la microscopia scanning capacitance (SCM) mappa la capacità o la densità di portatori locali. La microscopia scanning microwave (SMM) è unica nel rivelare strutture anche sotto la superficie che sono prevalenti nei moderni circuiti integrati (IC) multistrato.
 La microscopia scanning microwave (SMM) è una tecnica a scansione che misura le interazioni di una microonda proveniente da una punta AFM con il campione. Il coefficiente di riflessione delle microonde (parametro S11), che è il rapporto tra la potenza delle microonde inviate alla punta e quella ricevuta dopo essere stata riflessa sul contatto punta-campione, viene utilizzato per ricavare l'impedenza locale punta-campione delle microonde. Tale impedenza fornisce informazioni sulla capacità locale, da cui si possono dedurre la costante dielettrica e la densità di drogante. Per quanto riguarda la misura della densità di drogante, l'SMM è simile alla microscopia scanning capacitance (SCM), ma offre una gamma di misure più ampia. L'SMM può essere utilizzato per misurare non solo i semiconduttori, ma anche i materiali dielettrici e i metalli, poiché non si basa esclusivamente sulla modulazione della capacità di depletion nel campione.
La microscopia scanning microwave (SMM) è una tecnica a scansione che misura le interazioni di una microonda proveniente da una punta AFM con il campione. Il coefficiente di riflessione delle microonde (parametro S11), che è il rapporto tra la potenza delle microonde inviate alla punta e quella ricevuta dopo essere stata riflessa sul contatto punta-campione, viene utilizzato per ricavare l'impedenza locale punta-campione delle microonde. Tale impedenza fornisce informazioni sulla capacità locale, da cui si possono dedurre la costante dielettrica e la densità di drogante. Per quanto riguarda la misura della densità di drogante, l'SMM è simile alla microscopia scanning capacitance (SCM), ma offre una gamma di misure più ampia. L'SMM può essere utilizzato per misurare non solo i semiconduttori, ma anche i materiali dielettrici e i metalli, poiché non si basa esclusivamente sulla modulazione della capacità di depletion nel campione.
Nei materiali semiconduttori, una tensione alternata può modulare la densità di drogante nel campione sotto la punta, e quindi il segnale S11. Si tratta della cosiddetta misura dS/dV, che fornisce informazioni simili alla misura convenzionale dC/dV in SCM. La dS/dV è meno influenzata dalla topografia, ma funziona solo per i semiconduttori. Un altro vantaggio di questo metodo è che fornisce informazioni sul tipo di droganti (n o p) attraverso il cambiamento di fase.
A titolo di esempio, si vedano di seguito la topografia (a sinistra) e Im(S11) o la capacità (a destra) di un campione SRAM (dimensione della scansione 10 x 10 μm2) che presenta strutture con chiare differenze nel tipo e nella concentrazione di drogante. Dalle misure SMM è possibile identificare i difetti del dispositivo o i cambiamenti relativi nella concentrazione di drogante per valutarne le prestazioni o i potenziali siti di guasto.

Clicca qui per leggere l'App Note "Scanning Microwave Microscopy (SMM)" >>>
Calibrazione della capacità e misure di densità di drogaggio
Sebbene sia possibile estrarre i parametri elettronici locali del campione dalla misura SMM con metodi puramente analitici, i calcoli richiedono una conoscenza precisa dei parametri del campione e sono molto impegnativi dal punto di vista computazionale. Nei semiconduttori è inoltre necessario conoscere il modello di mobilità dei portatori da utilizzare. In pratica, un modo molto più rapido per ottenere dati quantitativi è la calibrazione delle misure su standard noti.
Di seguito riportiamo un esempio di calibrazione della misura S11 del campione di calibrazione della capacità di MC2 Technologies. (a) Schema del campione che mostra 4 terrazze, ciascuna alta 50 nm, con isole circolari d’oro sulla parte superiore da utilizzare come standard di capacità. (b) Topografia del campione, misurata in modalità a contatto, dimensioni della scansione: 52 x 52 μm2. (c,d) Immagini delle parti reali e immaginarie del parametro S11. (e) Immagine della capacità, opportunamente calibrata estratta dal parametro S11. I condensatori indicati con i numeri 1, 2 e 3 sono stati scelti come standard di calibrazione. Le rispettive capacità sono state stimate teoricamente come 0,3, 3,6 e 12,4 fF. Questi valori sono stati utilizzati per calcolare la mappa di capacità. (f) Sezione trasversale lungo la linea bianca in (e), che mostra il contrasto di una scansione sui due condensatori più piccoli. La più piccola variazione di capacità nell'immagine, il passo tra le terrazze, è di 0,04 fF.
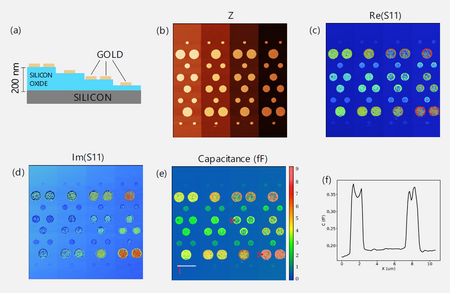
Di seguito riportiamo i dati sperimentali delle misure S11 (b,c) e dS/dV (d,e) del campione standard di calibrazione SCM Infineon. L'area è costituita da 20 regioni con drogaggio diverso: 10 per ogni tipo di drogaggio (n e p) con densità di drogaggio nell'intervallo 4⋅1015 - 1020 cm-3 La differenza tra S11 e dS/dV è chiaramente visibile. L'ampiezza del segnale S11 (b) aumenta monotonicamente con la densità del portatore, mentre il segnale dS/dV (d) ha l'ampiezza maggiore a metà dell'intervallo (1016-1018 cm-3). Il segnale di fase di dS/dV contiene informazioni sul tipo di droganti, n o p. Il profilo di drogaggio (f) è stato calcolato dalla misura S11 (b,c) opportunamente calibrata. Dimensioni dell'immagine (a,b,c,f): 50 x 50 μm2, (d,e): 35 x 35 μm2.

Scopri la nostra gamma di AFM >>>
| +39 06 5004204 | |
| +39 06 5010389 | |
| pergoliniqd-europe.com |


